基板の製造工程について(内層工程)
皆さんはプリント基板の製造工程をご覧になったことはありますか?基板のメーカーは大手から中小まで工場の規模も大小さまざまです。基板が使われている商品を考えてみてください。世界に数台しかない機械に使われることもあれば、ゲーム機や携帯電話のように数百万台も販売される機械にも使われています。基板メーカーは、それぞれの得意分野での生産をしているためにこれほどの規模の違いがあるのです。
しかし、ロットや仕様の差はあるものの、基本的な製造方法についてはほぼ統一されています。今回は基板ができあがるまでの工程を多層板のテンティング工法を参考に説明したいと思います。
今回は、多層板の内層工程の説明です。
- 材料切断
- 基板材料を投入サイズ(ワークサイズ)に切断します。
- フィルムラミネート
- 基板にドライフィルムを貼り付けます。
- 露光・現像
- 感光させてパターンを焼き付けます。
- 回路形成
- 感光しなかった部分の銅箔(不要な部分)をエッチングしてパターンを形成します。
- 黒化処理
- 酸化させることで銅箔面が粗くなり、プリプレグ(絶縁層、以下PPと呼びます)との密着性が向上します。
表面が黒く変色するため「黒化処理」と呼ばれます。 - 組み合わせ
- パターンを形成した内層材とPP、銅箔を組み合わせます。
組み合わせの方法には、マスラミネーション法(画像による位置合せ)とピンラミネーション法(ピンを使った位置合せ)の2つがあります。
回路がGNDや電源のベタパターンのみで構成されている場合は前者、回路に信号線が含まれる場合は後者の方法を使います。 - 積層プレス
- 組み合わせた材料をプレス機によって成型します。
- 外形加工
- 外形周囲に残った銅箔を除去します。
コストダウンのツボ
内層の工程は全てのメーカーが保有しているわけではありません。中小メーカーでは大手に加工を依頼している場合があるので、設計の段階で板取りの効率を考えて設計して頂いていれば即効性のあるコストダウンの手法が少ないのが現実です。
今回の工程の中で基板のコストダウンを考えるとすれば、まず、内層パターンの仕様です。内層パターンは外層ほど高密度にすることができない場合があります。設計の都合上同じグリッドで設計したら、製造で内層ショート多発、など笑えないことになる危険性があります。特に、初めて発注される基板メーカーの仕様については予め詳しく調べてください。また、外層の配線密度が高い(ピン間5本以上)場合には、内層のパターン仕様を外層と変える必要もあるかもしれません。要するに、最もコストパフォーマンスの高い基板仕様を選択して頂きたいということです。歩留まりの高い仕様であればコストダウンをメーカーに申し入れることができるかもしれません。
次に注意したいのは、組み合わせの工程です。[図1]と[図2]をご覧ください。どちらも同じ板厚ですが、PP(点線)の枚数が違います。図1では2枚使っているのに対して、図2では1枚になっています。図2の仕様であれば若干のコストダウンの可能性があります。
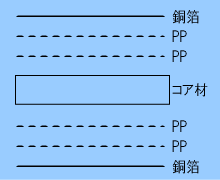
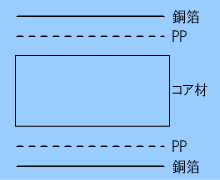
従来の多層板では、PPの枚数はあまり注目されませんでした。なぜ1枚で済む材料を2枚使用しているのかといえば、材料の標準化を進めるためと考えられますが、最近では材料メーカーの品揃えも豊富になり、このようなコストダウンの手法も注目され始めたようです。
具体的には、「コア材」「PP 」それぞれの厚さをコントロールすることで最も製造コストの安いものを選定します。
但し、この方法には問題点もあります。まず、基板のコストは多層板では変動費の比率が高く、小口品では効果が薄いこと。次に内層(シールド板)の生産を外注委託している場合に層構成を委託先が選択するためにコントロールしずらいことです。
新規に基板を作成する場合には、PPの枚数も量産品では価格に効いてくる場合があります。ただ、試作品と量産品の層構成を変えると基板のインピーダンスが変わってしまう場合があるので、予め層構成(PPや銅箔の厚さ)をご相談ください。私たちは、基板の仕様や用途から最もコストパフォーマンスが高い仕様をご提案することが可能です。

